月別ページ
-
自動車 電子・半導体 試験・分析・測定■TDDB試験の概要 半導体の酸化膜に電圧を継続的にかけていると、時間が経つにつれ酸化膜の破壊が発生します。 これを酸化膜破壊(TDDB: Time Dependent Dielectric Breakdown)といい、半導体の寿命や信頼性を考え…
-
解析技術:静電気破壊 〜SiC-MOSFET/ロックイン発熱解析/プラズマFIBの活用〜
自動車 電子・半導体 試験・分析・測定近年SiCやGaNといった次世代パワー半導体の開発・実用化が進み、故障解析技術に対する要求が高まっています。今回はSiC-MOSFETを例として、IEC61000-4-2に倣って静電気破壊試験を行った破壊品の解析事例をご紹介しま… -
電子・半導体 試験・分析・測定超音波顕微鏡では、2次元像(C-Scan)が標準的であるが、より視覚的・立体的に状態を捉えるために3次元化を目指しています。 ■時間軸解析(C-Scan)超音波顕微鏡では、主にA-Scanデータを基にして、外観上では確認…
-
従来のGaタイプのFIBと比べて大電流値での加工が可能になったため、数十μmの通常加工はもちろん500μmの大面積加工が可能です。 ■SiCを用いたGa-FIBとプラズマFIBの加工速度比較 Ga-FIBは5時間以上加工してもSiCの断…
- 1
- サイト内検索
- クオルテック公式サイト
- 新着ページ
-
- 基板の実装不良における様々な観察事例②(基板要因) (2024年04月16日)
- 車載部品における、耐油・耐薬品性能の試験方法をご提案します。 (2024年04月02日)
- 高温と低温の液媒体へ浸漬を繰り返し、急激な温度変化を与える「液槽冷熱衝撃試験」 (2024年03月19日)
- ガラス材の内部にレーザ加工する事により、表面に凹凸のないマーキングが可能です。 (2024年03月05日)
- CP加工(イオンミリング)による超精密試料 (2024年03月04日)



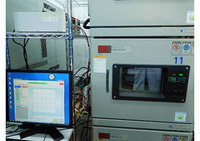



![足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内] 足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内]](https://www.atengineer.com/pr/qualtec/color/images/btn_wps.png)