事例
近年SiCやGaNといった次世代パワー半導体の開発・実用化が進み、故障解析技術に対する要求が高まっています。今回はSiC-MOSFETを例として、IEC61000-4-2に倣って静電気破壊試験を行った破壊品の解析事例をご紹介します。
■故障解析手順
■Step 1:SiCチップの故障箇所特定(X線観察・超音波顕微鏡・LIT)
●破壊したサンプルの外観観察、
及び非破壊検査acにおいては異常は
確認されませんでした。このことか
ら、故障規模が微小であることが推
察されます。
●レーザーと薬液開封によりSiCチップを露出し、LITによる発熱解析を行うことで微小な故障箇所を絞り込みました。
■Step 2:故障箇所の詳細解析(プラズマFIB・FE-SEM/EDS)
アルミ電極を除去後にIR-OBIRCHで故障箇所を特定し、
最新のプラズマFIB装置を用いてSiCチップの断面図を解析した結果、
故障したセルのトレンチゲート左側の酸化膜が破壊している様子が確認されました。
- サイト内検索
- クオルテック公式サイト
- 新着ページ
-
- 基板の実装不良における様々な観察事例②(基板要因) (2024年04月16日)
- 車載部品における、耐油・耐薬品性能の試験方法をご提案します。 (2024年04月02日)
- 高温と低温の液媒体へ浸漬を繰り返し、急激な温度変化を与える「液槽冷熱衝撃試験」 (2024年03月19日)
- ガラス材の内部にレーザ加工する事により、表面に凹凸のないマーキングが可能です。 (2024年03月05日)
- CP加工(イオンミリング)による超精密試料 (2024年03月04日)




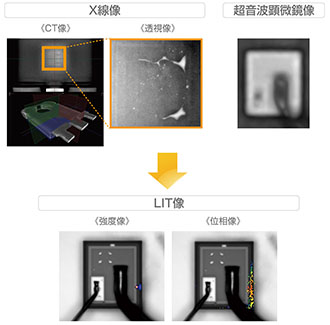
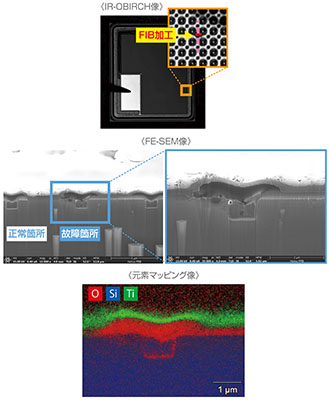


![足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内] 足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内]](https://www.atengineer.com/pr/qualtec/color/images/btn_wps.png)