市場や実装工程で生じた部品の故障状況を把握し、電気特性の測定や様々な観察・解析をする事により故障原因の究明を行うのが[故障解析]です。故障を発生させている製造ロットを特定し、問題の広がりを最低限に抑え、製造または使用上の改善を導く事で、製品の品質と製造者の信頼性を確保する事を目的としています。
LSI・抵抗・コンデンサ・スイッチ・コネクタ・プリント回路基板等電子部品から電気部品・接点の故障まで広範囲の故障解析を実施しています。
故障解析の実施手順
基本的な実施手順を以下に記載します。 状況に応じて適切な項目を選択、実施します。
■外観観察
光学顕微鏡(OM)を用いて細部まで観察します。
ボイド・ピンホール、パッケージクラック、機械的損傷、外部端子間に発生する導電性の異物付着、汚染、リード変色、イオンマイグレーション、リードの応力腐食割れなど、必要に応じ走査型電子顕微鏡(SEM)で詳細に観察します。
■電気的特性測定
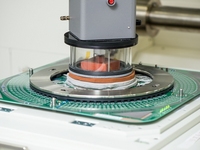
■透過X線観察
パッケージを分解せずに、マイクロX線CT装置(XCT)やマイクロフォーカスX線装置を用いてデバイス内部の組立構造(ワイヤボンドの状態、チップとダイパッド間の銀ペーストの濡れ性、モールド樹脂のボイドの有無など)を検査します。
X線観察は分解前に内部構造を把握する意味でも重要です。
■超音波探査
パッケージを分解する前に、超音波顕微鏡(SAT)を用いて、パッケージ内部の接合状態を観察し、剥離やクラックなどを確認します。剥離の有無については解析画像、反射波形、リファレンスサンプルの比較などで総合的に判断します。
■ロックイン赤外線発熱解析
パッケージを分解する前に、ロックイン赤外線発熱解析装置(LIT)を用いて、ショート、リーク等に伴う発熱箇所を
特定し、故障部位を絞込みます。通常のLSIだけでなく、微細化、積層化した電子部品やユニット等の解析にも有効です。
■分解・開封
故障部位を観察できるよう、パッケージを分解・開封します。故障箇所を損傷しないよう適切な方法を選択し、極力機能特性を保持した状態で分解・開封を実施します。
■内部観察
光学顕微鏡(OM)、走査型電子顕微鏡(SEM)などを用いて故障箇所を詳細に観察します。
■断面構造観察
劈開、機械的研磨、収束イオンビーム装置(FIB; Focused Ion Beam)などにより、対象断面部位を露出させ、積層構造の不具合や異物混入、コンタクトホールの異常等を観察します。
■発熱解析

当社は、検出感度が極めて高いロックイン赤外線発熱解析装置を用いて解析を行います。
■発光解析(PEM)
電流リークに伴って発生する極微弱な光を検出することにより、故障箇所を特定することができます。
■界層解析/エッチバック解析
LSIチップの積層膜を順次除去し、走査型電子顕微鏡(SEM)などを用いて観察します。
■元素分析
観察された異物、積層構造の構成元素を電子線マイクロ分析(EPMA-WDX、SEM-EDX、TEM-EDXなど)により特定します。
■故障メカニズム推定
上記の解析で取得した情報や、故障を検証するためのシミュレーション結果、および当社が過去に実施した故障解析のデータベースを活用し、故障メカニズムを客観的に推定します。
解析(故障/良品)・観察・分析のお問い合わせ
解析(故障/良品)・観察・分析について、OKIエンジニアリングまでお気軽にお問い合わせください。
お見積りのご依頼や試験可否については、製品や部品の品名情報、詳しい試験や分析の条件についてお知らせいただけるとスムーズです。
【このページの関連ページ】
- サイト内検索
- オフィシャルサイト
- ページカテゴリ一覧
- 新着ページ
-
- 【新サービス】マルチメディア機器向けの新たなEMC試験サービスを開始 (2026年04月23日)
- PIND:Particle Impact Noise Detection(微粒子衝撃雑音検出試験) (2026年04月20日)
- 人とくるまのテクノロジー展 2026 YOKOHAMAに出展 (2026年04月16日)
- スプラッシュウォーター試験(水はね試験) (2026年03月25日)
- 【新規設備】車載機器向け「スプラッシュウォーター試験」を自動化 (2026年03月25日)





![足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内] 足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内]](https://www.atengineer.com/pr/oeg/color/images/btn_wps.png)