
市場や製品開発時に発生した不具合、故障に対して、OKIエンジニアリングはロックイン赤外線発熱解析を用いて故障箇所を特定する解析に始まり、故障メカニズムの推定のための評価・解析、および検証実験に至るまでの各種評価をワンストップでご提供いたします。
■特長
・LSI、電子部品等の故障箇所を非破壊で特定可能
・多層基板や積層構造部品の解析も可能
・印加電圧は±3000Vまで可能で、高耐圧素子の解析にも対応
・高密度実装多層基板や最先端パッケージ部品に対応(自社製プロービングシステムによる)
■原理概略
対象試料にパルス電圧を印加しながら、試料表面を赤外線カメラで撮影します。このときパルス電圧と同期した発熱のみを抽出することで感度を向上させます。(ロックイン解析)
また、表面温度の上昇は発熱点から表面に伝わる時間分だけ遅れるため、パルス電圧と温度変化の時間差(位相差)から、故障箇所の深さ方向の位置を推定することができます。
■解析事例
対象試料:ESD試験機を用いて高電圧を印加し、ショート故障状態にしたIC


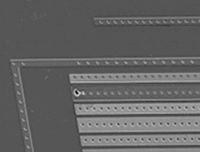
解析(故障/良品)・観察・分析のお問い合わせ
解析(故障/良品)・観察・分析について、OKIエンジニアリングまでお気軽にお問い合わせください。
お見積りのご依頼や試験可否については、製品や部品の品名情報、詳しい試験や分析の条件についてお知らせいただけるとスムーズです。
【このページの関連ページ】
- サイト内検索
- オフィシャルサイト
- ページカテゴリ一覧
- 新着ページ
-
- BATTERY JAPAN 二次電池展 インタビュー動画 (2025年10月29日)
- 「TECHNO-FRONTIER 2025(テクノフロンティア)」 出展レポート (2025年10月02日)
- 高崎ラボ開所に至るまで (2025年09月02日)
- 「人とくるまのテクノロジー展2025 YOKOHAMA」出展レポート (2025年06月17日)
- REACH規則対応高懸念物質(SVHC)35次リスト候補 3物質 分析サービス開始 (2024年07月12日)



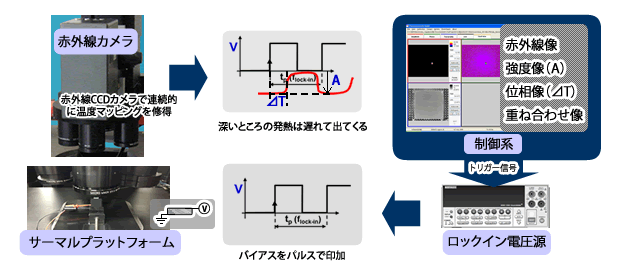

![足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内] 足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内]](https://www.atengineer.com/pr/oeg/color/images/btn_wps.png)