パッケージ接続強度評価
スマートフォンやタブレットなどで使用される半導体パッケージは、Au(金)の高騰化、環境保全対応(鉛フリー)、微細化、高密度化が進み、フリップチップ接合もバンプピッチの微細化にともない多様な方法が開発、実用化されつつあります。OKIエンジニアリングでは、各種電子部品、ICやLSI等におけるパッケージ内の接続強度評価をご提供します。長期的な信頼性を評価するため、熱衝撃試験や振動試験等の組み合わせによる良品解析(LSIプロセス診断など)により、高密度半導体の開発および信頼性品質確保を支援いたします。
試験項目一覧
| ■ ワイヤプルテスト | ■ ワイヤボンドシェアテスト |
| ■ リボンシェアテスト | ■ ワイヤツィーザープルテスト |
| ■ ダイシェアテスト | ■ リードプル・ピールテスト |
| ■ はんだボールプルテスト | ■ はんだボールシェアテスト |
| ■ トータルボールシェアテスト | ■ オートグラフ[精密万能試験機] (引っ張り、押し試験) |
パッケージの接続強度評価サービス事例 |
パッケージ内実装に、従来のPb-Sn(鉛すず)はんだボールに代えて、銅(Cu)ピラー構造のバンプ(CPB:Copper Pillar Bumping)を使用するなどの最新パッケージ技術にも、接続強度評価および良品解析(LSIプロセス診断など)は対応しています。
パッケージの接続強度評価サービスの対象製品分野
| ■ 車載デバイス | ■ パワーデバイス | ■ 航空・宇宙・防衛 |
| ■ 光通信デバイ | ■ CMOS・CCD | ■ LED |
適用例
| ■ 金ワイヤ・アルミワイヤ・銅ワイヤ・銀ワイヤ・リボンのプル |
||
| ■ シェア、表面実装部品 | ||
| ■ 溶接部品のシェア、フリップチップのシェア |
接続強度試験方法
ワイヤボンディングの強度の試験を行うことによって得られる物理強度数値は、耐久性試験のための目安となります。
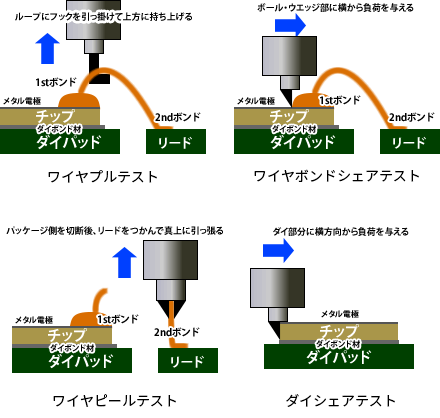 |
パッケージの接続強度評価サービス |
ワイヤプルテスト
|
ボンディングワイヤのループ部分にひっかけて引張り、 破断時の強度を測定評価します。
■ 対応規格:MIL STD 883,IEC 60749-22, SEMI G73-997,JEITA ED-4703 |

パワーデバイスのアルミ線ワイヤ プルテスト |
ワイヤボンドシェアテスト
|
ファーストボンド、セカンドボンドなどを規定の治具で 押し、破壊時の強度を測定評価します。
■ 対応規格:MIL STD 883,IEC 60749-22, JEITA ED-4703,JESD22-B116
|
ワイヤボンドシェアテスト
|
リボンシェアテスト
|
リボン型リードの接続部を横から規定の治具で押し、 負荷をかけ、破壊時の強度を測定します。 |
ワイヤツィーザープルテスト
|
ワイヤボンディングのセカンドワイヤやウェッジ部分の接合 を対象とし、ワイヤを規定の治具でつかみ垂直に引き上げ、 破壊時の強度を測定評価します。
■ 対応規格:IEC-60749-22 |
ワイヤツィーザープルテスト |
ダイシェアテスト
|
基材(リードフレーム、基板)に接合された半導体ダイを対象に、ダイを横から規定の治具で押し、負荷をかけ、破壊時の強度を測定評価します。半導体ダイだけでなく、受動素子も可能です。
■ 対応規格:MIL STD 883,IEC 60749-19,JEITA ED- 4703,SEMI G63-95 |
ダイシェアテスト
|
リードプル・ピールテスト
|
QFPやSOPなどの部品のリードと基板の接続強度を測定評価 します。対象を45度に設置し、リード部分にフックを引っかけ垂直方向に引っ張り剥がれたときの強度を測定評価する方法:JIS Z 3198-6規格も対応可能です。
■ 対応規格:JIS Z 3198-6(QFP リードのはんだ継手 45 度 プル試験) |
リードピールテスト
|
はんだボールプルテスト
|
BGAやCSPなどのはんだボールを挟み込み、引き上げ把持方法で破断時の強度を測定評価します。
■ 対応規格:JESD22-B115 |
 はんだボールプルテスト |
はんだボールシェアテスト
|
QFPやSOPなどの部品のリードと基板の接続強度を測定評価します。 対象を45度に設置し、リード部分にフックを引っかけ垂直方向に引っ 張り剥がれたときの強度を測定評価する方法:JIS Z 3198-6規格も対応可能です。
■ JI対応規格:JESD22-B117A |
はんだボールシェアテスト
|
トータルボールシェアテスト
|
BGAやCSPなどのはんだボールを横から適当な治具で押し、 破壊時の強度を測定評価します。
|
トータルボールシェアテスト
|
|
MIL-STD-883: 集積回路の試験方法と手順の規格であり、米軍調達品としての一般要求事項、機械的、環境、耐久性試験、電気的試験方法および品質保証の方法と手順を規定したもの |
|
JEITA ED-4703 : 半導体デバイスの工程内の半製品の評価および構造解析を通じて工程の適合性を確認するための標準的な方法〔外部目視、内部目視、ダイボンド強度(ダイシェア)、ワイヤボンド強度(ワイヤプル)、ワイヤボンド強度(ボールシェア)〕について規定 |
|
JIS Z 3198-6 : QFPリードのはんだ継ぎ手45度プル断試験方法 |
オートグラフ[精密万能試験機](引っ張り、押し試験) |
オートグラフ[精密万能試験機](引っ張り、押し試験)は、製品や樹脂材料の機械的強度特性や実装部品のせん断力を測定し、はんだの接合強度を評価するための試験です。破断点・弾性率・耐力点・上降伏点・下降伏点等の測定が可能です。また、オートグラフと恒温槽による温度環境下における影響を評価する事も可能です。
適用例
| ■ JIS Z 3198-5 : はんだ継ぎ手の引張りおよびせん断試験方法 |
| ■ JIS Z 3198-6 : QFPリードのはんだ継ぎ手45度プル断試験方法 |
| ■ JIS Z 3198-7 : チップ部品のはんだ継ぎ手せん断試験方法 |
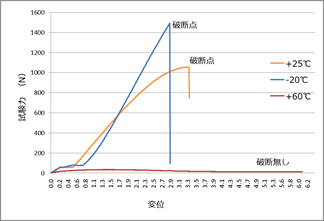 万能試験機による破断点測定結果 万能試験機による破断点測定結果 |
|
[精密万能試験機] |
[精密万能試験機] |
使用設備 |
ワイヤボンドプルテスタ
|
最大測定強度 |
プル:100[kgf] シェア:200[kgf] ツィザー:5[kgf] プッシュ:100[kgf] |
| 測定強度 | プル:1[um/s]~5.0[mm/s] シェア:1[um/s]~5.0[mm/s] |
| 搭載可能サンプルサイズ | 最大対応幅:約186[mm] |
ワイヤボンドプルテスタ
オートグラフ[精密万能試験機]
■オートグラフ[精密万能試験機] 型名:AGS-J
| 製造者 | 島津製作所 |
| 主な仕様 | 最大荷重:5kN(500kgf) ロードセル:100N,500N,5kN クロスヘッド速度範囲:0.5~500mm/min |
■オートグラフ用恒温槽 型名:TCR-2
| 製造者 | 島津製作所 |
| 主な仕様 | 最大荷重:5kN(500kgf) ロードセル:100N,500N,5kN クロスヘッド速度範囲:0.5~500mm/min |
解析(故障/良品)・観察・分析のお問い合わせ
解析(故障/良品)・観察・分析について、OKIエンジニアリングまでお気軽にお問い合わせください。
- サイト内検索
- オフィシャルサイト
- ページカテゴリ一覧
- 新着ページ
-
- 【新サービス】マルチメディア機器向けの新たなEMC試験サービスを開始 (2026年04月23日)
- PIND:Particle Impact Noise Detection(微粒子衝撃雑音検出試験) (2026年04月20日)
- 人とくるまのテクノロジー展 2026 YOKOHAMAに出展 (2026年04月16日)
- スプラッシュウォーター試験(水はね試験) (2026年03月25日)
- 【新規設備】車載機器向け「スプラッシュウォーター試験」を自動化 (2026年03月25日)






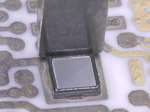
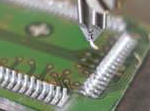


 オートグラフ
オートグラフ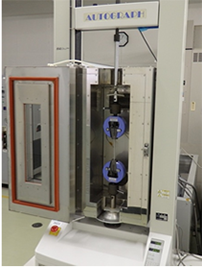 恒温槽付きオートグラフ
恒温槽付きオートグラフ

![足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内] 足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内]](https://www.atengineer.com/pr/oeg/color/images/btn_wps.png)