SIMS分析概略
SIMS(Secondary ion mass spectrometry : 二次イオン質量分析法)は極低濃度のドーパントや不純物を検出する分析手法です。試料表面を一次イオンでスパッタし、スパッタによって放出された二次イオンを四重極型(Quadruple)・磁場型(Sector)等の質量分析計で分離、検出します。SIMSではHを含めた全元素をppm〜pptの感度で深さ方向分析を行うことができます。
EAG LaboratoriesはSIMS分析で業界最大の技術力を誇っています。世界最大規模のSIMS所有台数(50台以上)を誇り、7000種類以上の標準試料を所有しています。微量不純物元素に対して正確な濃度定量と高感度な検出下限値を提供しています。
また、EAG Laboratoriesが独自開発したPCOR-SIMS(Point by point Corrected SIMS)は化合物半導体の微量元素・組成評価、Shallow B、As、P等の極浅イオン注入(ULE)分布評価などに有効です。
*各分析手法の分析深さはSMART Chartからご覧いただけます
対象分野
- 半導体
- エレクトロニクス
- 自動車
- 航空宇宙
- 鉄鋼
- 先端材料
- エネルギー
用途事例
- 薄膜中のドーパント濃度、深さ方向分析
- イオン注入元素濃度、深さ方向分析
- 薄膜中の汚染元素濃度、深さ方向分析
- 薄膜構造解析
- 薄膜の膜厚調査
- 界面汚染調査
- 薄膜組成分析(特定の膜種のみ可能)
対象試料の事例
- Si半導体デバイス及び関連材料(SiO2・SiN等)
- 化合物半導体材料・デバイス III-V系(AlN・GaAs・InP・GaN等)
- SiC及びII-VI系材料 (HgCdTe・ZnSe等)
- 極表面汚染分析(Surface SIMS)
- 極浅接合形成イオン注入深さ方向分析(ULE)
- 太陽電池材料関連(PV-Si・CIG等)
- FPD材料関連(有機EL等)
- 金属薄膜(Cu膜・Ti膜・W膜・Al膜等)
- 絶縁膜、コーティング膜、各種薄膜
原理/特徴
一次イオン
スパッタリングに用いられる一次イオンは酸素(O2+)またはセシウム(Cs+)を使用します。検出元素に対するイオンビームの使い分けは下記図をご参照ください。通常2〜20数十umほどに絞った一次イオンビームを四角に走査させて試料をスパッタリングします。走査(ラスター)面積は、通常数100μm~数10μm角程度です。
二次イオン
スパッタリングにより形成された二次イオンは質量分析系で分離されたのち、ファラデーカップまたはエレクトロンマルチプライヤーで検出します。
精度の高い深さ方向分解能を得るため、ラスター領域中心部分(φ30~150um程度)の二次イオンのみが検出されます。
装置構成
| 質量分析計 | 磁場型(Sector) | 四重極型(Q-pole) |
| メリット |
|
|
| デメリット |
|
|
分析事例
SIMS:Si基板中に11B、P、Asをイオン注入した後の深さ方向濃度分析
測定材料ごとに最適化されたSIMSを用いることで、高感度で高精度な分析が可能。
SIMS:酸化膜中における可動イオンのイオン注入分布評価
EAG Laboratoriesでは適切なチャージアップ補正を行い、絶縁膜中の可動イオン(Li、Na、K等)の正確な分析が可能。
SIMS:セミバルクモードを用いたSiC試料中の金属不純物分析
一般的に磁場型のSIMSでは困難とされる多元素測定を、セミバルクモードを用いることでSiC中のAl、Na、V、Ti、Cr、Fe、Ni、Cuをリーズナブルな検出下限値で分析可能。
分析に適した試料量/形状
形状:推奨10×10mm(厚み0.5~3mm)、
最小8×6mm(厚み0.5~3mm)で表面鏡面仕上げ
※上記以外の形状・サイズについても対応可能です、ご相談ください
関連のある分析手法
SMART Chart
分析深さ一覧
- サイト内検索
- 新着ページ
-
- SEM-CL:カソードルミネッセンス分析 (2024年07月26日)
- TEM-EDS/EELS:透過型電子顕微鏡・元素分析 (2024年07月22日)
- PCOR-SIMS:Point by point Corrected 二次イオン質量分析法 (2024年07月17日)
- FIB-SEM:集束イオンビーム分析 (2024年07月09日)
- Kr85リーク試験:封止パッケージの気密性試験 (2024年05月27日)




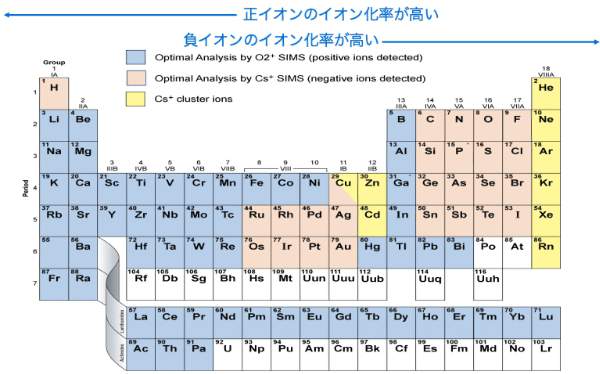

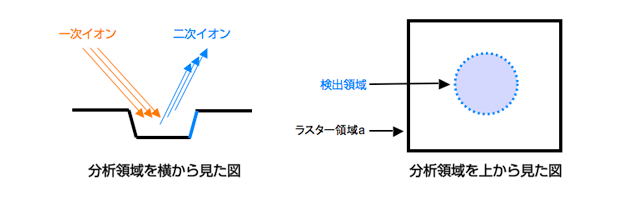
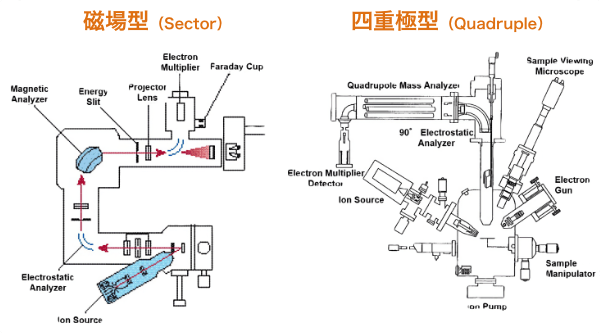




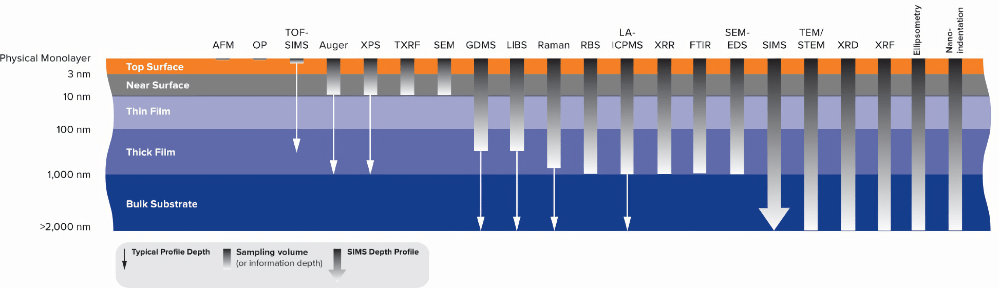




![足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内] 足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内]](https://www.atengineer.com/pr/eag/color/images/btn_wps.png)