PCOR-SIMS:
Point by point Corrected 二次イオン質量分析法
PCOR-SIMS(Point by point Corrected SIMS)はSIMSをベースに、EAG Laboratoriesが長年の経験とノウハウから独自開発した分析手法です。
試料のマトリクスの変化に対して感度係数とスパッタリングレートを深さ方向全てのポイントに対して補正し、精度の高い深さ方向プロファイルを得ることが可能な高度なEnhanced SIMS技術です。
PCOR-SIMSは化合物半導体の微量元素・組成評価、Shallow B、As、P等の極浅イオン注入(ULE)分布評価などに有効です。
*各分析手法の分析深さはSMART Chartからご覧いただけます
対象分野
- 半導体
- エレクトロニクス
- 自動車
- 航空宇宙
用途事例
- 化合物半導体中のドーパント濃度深さ方向分析
- 化合物半導体中のエピタキシャル層の膜厚分析
- Si基板中の極低エネルギーイオン注入分布評価
対象試料の事例
- 化合物半導体材料・デバイス III-V系(AlN、GaAs、InP、GaN等)
- SiGe材料
- 極浅接合形成イオン注入深さ方向分析(ULE)B、P、Asイオン注入分布評価
原理/特徴
一次イオン
一次イオンでは酸素(O2+)またはセシウム(Cs+)を使用します。通常2〜20umほどに絞った一次イオンビームを四角にラスター(スキャン)させて試料をスパッタリングします。ラスター面積は、通常数100 μm~数10μm角になります。
二次イオン
ラスター領域から発生した二次イオンの中心領域のみを検出するします。その領域サイズはφ30~150 um(検出感度や試料状態で調整)になります。二次イオン系(電場、磁場)で質量分離されたのち、検出器(ファラデーカップまたはエレクトロンマルチプライヤー)で検出します。
分析事例
PCOR-SIMS:化合物半導体AlGaAsの評価
(VCSEL LASER深さ方向組成、不純物濃度分析)
AlGaAs/GaAs多層エピタキシャル成長膜中のドーパント、不純物元素の正確な濃度定量、精度の高い深さ換算データの提供が可能。
表面からGaAs基板まで高い深さ方向分解能を保つ分析が可能なため、多層薄膜界面における炭素、酸素のスパイクを確認することが可能。
PCOR-SIMS:テへテロバイポーラトランジスタ(HBT)の分析
InGaP エミッタ HBT構造の不純物深さ方向分析(InGaAs、InGaP、GaAsの各層中で正確な濃度を分析)
PCOR-SIMS:Si基板へのBの極浅注入分布評価
プレアモルファス化条件の違いによる100eV注入のB極浅深さ濃度分布。
(Ge、Xeによるプレアモルファス化した条件と接合深さの相違点が判明、PCOR-SIMSでは酸素のモ二ターも可能)
分析に適した試料量/形状
- 形状:推奨10×10mm(厚み0.5~3mm)、
最小8×6mm(厚み0.5~3mm)で表面鏡面仕上げ
(上記以外の形状・サイズについても対応可能です、弊社までご相談ください)
関連のある分析手法
SMART Chart
分析深さ一覧
- サイト内検索
- 新着ページ
-
- SEM-CL:カソードルミネッセンス分析 (2024年07月26日)
- TEM-EDS/EELS:透過型電子顕微鏡・元素分析 (2024年07月22日)
- PCOR-SIMS:Point by point Corrected 二次イオン質量分析法 (2024年07月17日)
- FIB-SEM:集束イオンビーム分析 (2024年07月09日)
- Kr85リーク試験:封止パッケージの気密性試験 (2024年05月27日)




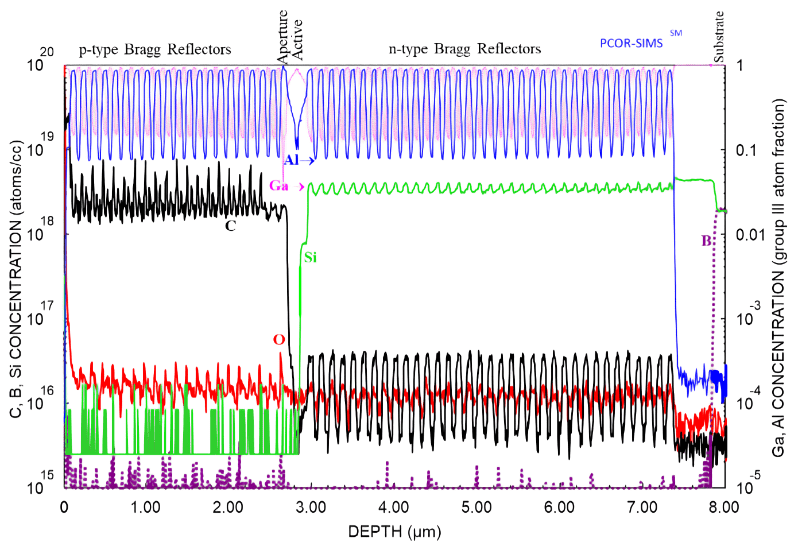

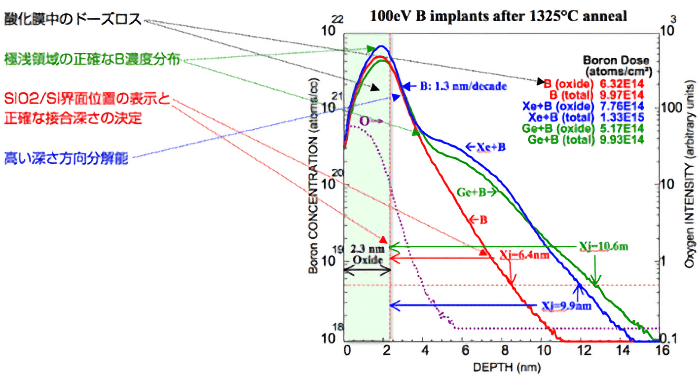


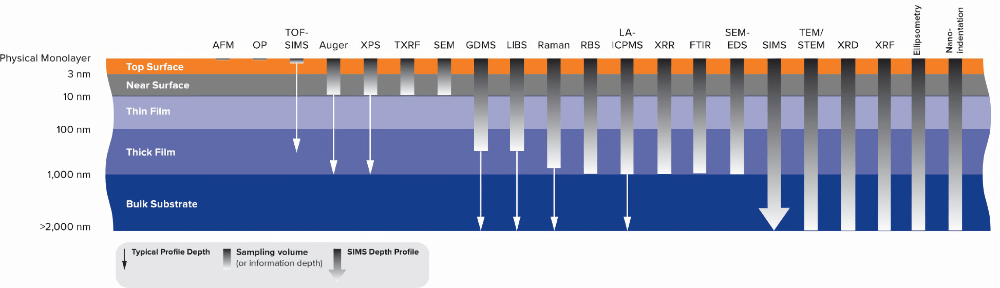




![足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内] 足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内]](https://www.atengineer.com/pr/eag/color/images/btn_wps.png)