「TEM/STEM」一覧
すべてのページカテゴリ一覧
»
「TEM/STEM」に関するページ
-
TXRF分析概略TXRF(Total reflection x-ray fluorescence : 全反射蛍光X線分析)は半導体ウエハ表面の微量金属汚染の評価に用いています。洗浄など、製造製造工程でウエハ表面に付着した金属汚染の分析に有効です。…
-
TEM/STEM-EDS/EELS:TEM/STEM-エネルギー分散型X線分光法/電子エネルギー損失分光法
TEM/STEM-EDS/EELS:分析概略TEM/STEMを用いた元素分析です。EDS(Energy Dispersive X-ray Spectroscopy:ネルギー分散型X線分光法)は比較的重元素の測定に向いており、EELS(Electron Energy Loss Spectroscopy:… -
SIMS分析概略SIMS(Secondary ion mass spectrometry : 二次イオン質量分析法)は極低濃度のドーパントや不純物を検出する分析手法です。試料表面を一次イオンでスパッタし、スパッタによって放出された二次イオンを…
-
TEM/STEM分析概略TEM/STEM(Transmission Electron Microscope/Scanning transmission electron microscope:透過型電子顕微鏡/走査型透過型電子顕微鏡分析)は、電子ビームを使用してサンプルを画像化する分析手法…
- 1
- サイト内検索
- 新着ページ
-
- SEM-CL:カソードルミネッセンス分析 (2024年07月26日)
- TEM-EDS/EELS:透過型電子顕微鏡・元素分析 (2024年07月22日)
- PCOR-SIMS:Point by point Corrected 二次イオン質量分析法 (2024年07月17日)
- FIB-SEM:集束イオンビーム分析 (2024年07月09日)
- Kr85リーク試験:封止パッケージの気密性試験 (2024年05月27日)







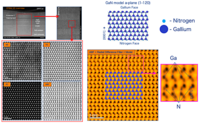

![足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内] 足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内]](https://www.atengineer.com/pr/eag/color/images/btn_wps.png)