FIB-SEM:集束イオンビーム分析概略
FIB(Focused Ion Beam:集束イオンビーム)は微細に集束されたイオンビームを使用して試料の加工・イオン像の観察が行なえます。FIB-SEMは高解像度のFE-SEM(電界放出電子顕微鏡)を搭載しており、高分解能での観察と加工が同時に行えるのが特徴です。
主な使用目的は”試料の断面加工(断面SEM)”・”TEM/STEM分析用薄片試料作成”・”断面加工と撮影を繰り返し行い、試料構造を三次元化での解析(三次元再構築)”・”半導体の回路修正”などです。
さらにEAG Laboratoriesでは最新のクライオ(冷却)機能を搭載したFIB-SEMも所有し、樹脂試料や金属試料を冷却し、FIBによる熱ダメージを軽減した試料加工にも対応しています。
*各分析手法の分析深さはSMART Chartからご覧いただけます
対象分野
- 半導体
- エレクトロニクス
- 自動車
- 航空宇宙
- 鉄鋼
- 先端材料
- エネルギー
- メディカルデバイス
用途事例
| 加工 | 三次元再構築 |
|
|
原理/特徴
高分解能FE-SEM(電界放出走査顕微鏡)にFIB(集束イオンビーム加工装置)が搭載された装置になります。別名でデュアルビームとも呼ばれており、SEM観察を行いながらイオンビームで試料の加工が行なえます。
- SEMを搭載しているためSEM領域では高分解能観察が可能
- SIM像(二次イオン像)と
SEM像(SE像・反射電子像:Zコントラスト)の両方が取得可能 - 微小領域の加工が可能
- 三次元再構築ではSEM像だけではなくEDSでも対応可能
- クライオ搭載型FIB-SEMでは樹脂試料や金属試料を最大-135℃で冷却し
FIBによる熱ダメージを低減した試料加工が可能
検出原理
FIB(イオンビーム)で試料の断面加工とSEM像の撮影を繰り返し行い、三次元像を再構築します。
分析ビーム選択と検出下限
FIB(イオンビーム)で試料の薄片化を行い、専用のプローブでTEMのグリッドに貼り付けます。薄片が貼り付けられたグリッドをTEMにセットし、高分解能のTEM観察が可能になります。
分析事例
サファイア基板上のGaN膜(同一試料をTEMとSTEMで観察し比較)
バッテリーのアノードに10um以下の微小なSiO2粒子が混在していることを確認可能。
FIB-SEM:金属粒子の三次元再構築
20nmのスライスピッチで断面加工と撮影を繰り返し、三次元解析が可能。
FIB-SEM:三次元再構し、試料内部の粒子数をカウント
専用の画像処理ソフトウェアにより微小試料内部の粒径分布・欠陥の原因究明などに応用可能。
FIB-SEM:クライオ(冷却)FIBを用いたリチウム金属の断面加工
最大-135℃で試料を冷却することにより試料への熱ダメージを抑え、滑らかでダメージの少ない断面加工が可能。
関連のある分析手法
SMART Chart
分析深さ一覧
- サイト内検索
- 新着ページ
-
- SEM-CL:カソードルミネッセンス分析 (2024年07月26日)
- TEM-EDS/EELS:透過型電子顕微鏡・元素分析 (2024年07月22日)
- PCOR-SIMS:Point by point Corrected 二次イオン質量分析法 (2024年07月17日)
- FIB-SEM:集束イオンビーム分析 (2024年07月09日)
- Kr85リーク試験:封止パッケージの気密性試験 (2024年05月27日)




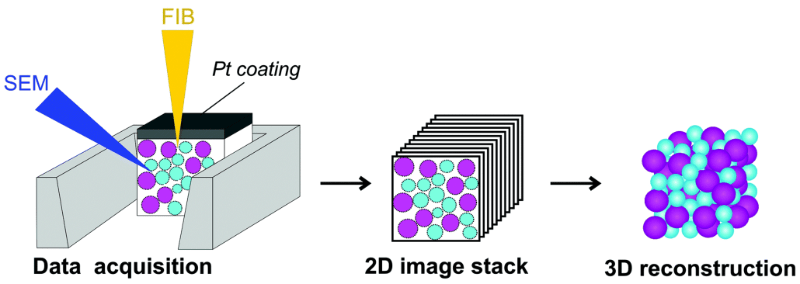

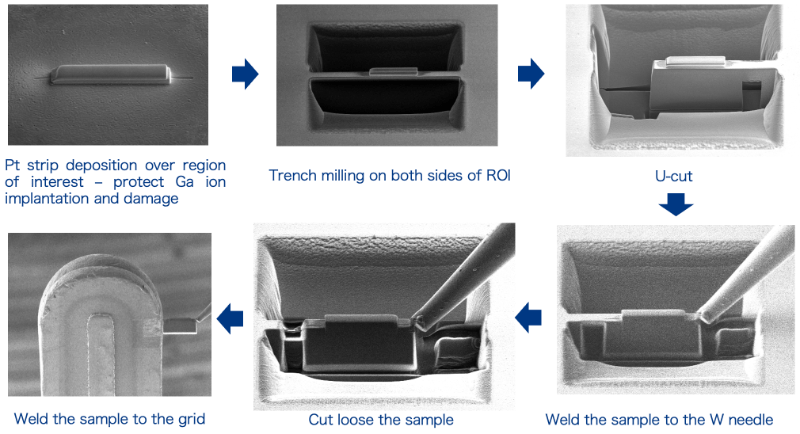

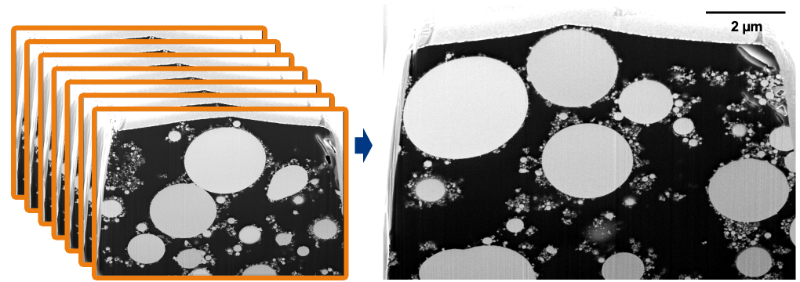

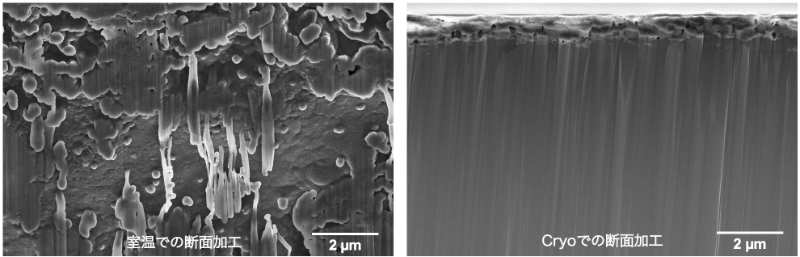

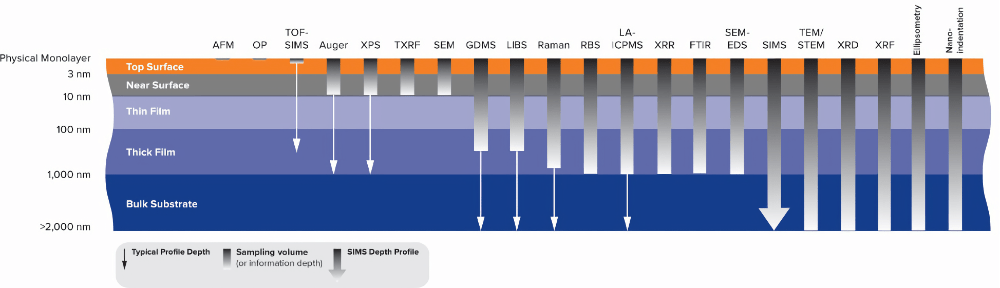




![足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内] 足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内]](https://www.atengineer.com/pr/eag/color/images/btn_wps.png)