製品・技術
RBS:ラザフォード後方散乱分析概略
RBS(Rutherford Backscattering Spectrometry:ラザフォード後方散乱分析)では、He等の軽いイオンをMeV程度の高エネルギーに加速して固体に照射することで固体元素の原子核により後方側に散乱されたイオンのエネルギーを測定することで、固体中に含まれる原子の組成・量・深さ方向分布を分析することができます。
HFS(水素前方散乱分析)を併用することによりHを含めた薄膜の組成・深さ方向分布が高精度で分かります。さらにPIXE(粒子励起X線分析)・NRA(核反応分析)を組み合わせることも可能です。
*各分析手法の分析深さはSMART Chartからご覧いただけます
加速粒子分析手法
- RBS:Rutherford Backscattering Spectrometry(ラザフォード後方散乱分析)
- HFS:Hydrogen Forward Scattering(水素前方散乱分析)
- PIXE:Particle Induced X-ray Emission(粒子励起X線分析)
- NRA:Nuclear Reaction Analysis(核反応分析)
対象分野
- 半導体
- エレクトロニクス
- 自動車
- 航空宇宙
- 鉄鋼
- 先端材料
- エネルギー
対象試料の事例
| シリサイド膜 | WSiPt、Si、TiSi、CoSi、CrSi、NiSi、PdSi |
| 金属・合金 | Al、Ti、Cu、Mo、W、Pt、Ag、AlCu、PtMn、TiW、PtFe、 IrMn |
| バリア膜 | TiN、TaN |
| 絶縁膜・ コーティング膜 |
SiO、SiN、SiON、HfSiO、FSG、BSG、BPSG、HSQ、 SiOC、polyimide、Teflon、DLC、SOI、BST、STO、PZT、 SBT |
| 半導体薄膜・ 酸化物半導体薄膜 |
SiGe、 AlGaN、InGaN、IGZO |
原理/特徴
RBS/HFS/PIXE/NRAの高加速イオンビームプロセス
特徴
He+ ・He2+などの軽いイオンを数MeVのエネルギーに加速し分析磁場を通してイオン種とエネルギー揃え、試料表面に照射。固体中の原子核によりラザフォード後方散乱されたイオンのエネルギーを検出します。
- 非破壊で深さ方向(1um程度)の組成分析が可能
- 結晶性評価(元素の格子位置・結晶欠陥)が可能
- 絶対定量が可能
- 構成原子の物理量(散乱確率)が判明しているため標準試料による定量が不要
検出器構成
装置構成
- He+ ・He2+などの軽いイオンを数MeVのエネルギーに加速し
分析磁場を通してイオン種とエネルギー揃え、試料表面に照射 - RBSの通常の条件では2.2 MeVの He2+ イオンを使用
分析事例
RBS & HFS
SiN薄膜の評価
RBS & NRA
TiO2薄膜の評価
RBS & PIXE
スチール薄膜の評価
分析に適した試料量/形状
形状:薄膜の膜厚〜1um、面積2mm■以上
関連のある分析手法
SMART Chart
分析深さ一覧
- サイト内検索
- 新着ページ
-
- SEM-CL:カソードルミネッセンス分析 (2024年07月26日)
- TEM-EDS/EELS:透過型電子顕微鏡・元素分析 (2024年07月22日)
- PCOR-SIMS:Point by point Corrected 二次イオン質量分析法 (2024年07月17日)
- FIB-SEM:集束イオンビーム分析 (2024年07月09日)
- Kr85リーク試験:封止パッケージの気密性試験 (2024年05月27日)




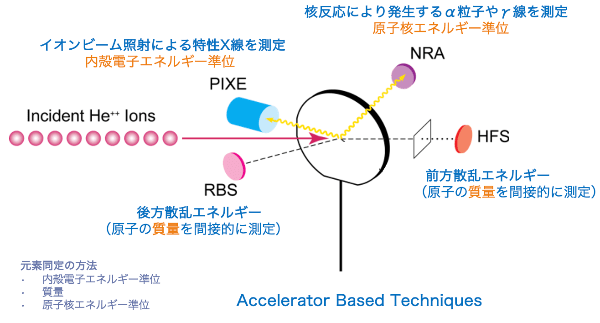

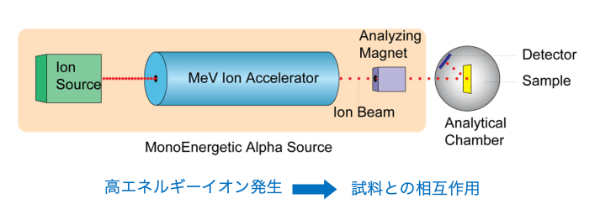


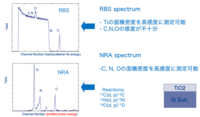
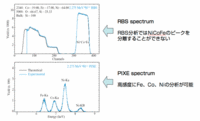


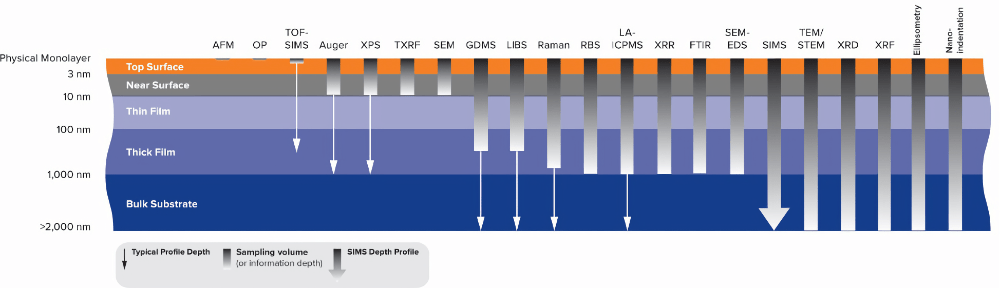



![足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内] 足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内]](https://www.atengineer.com/pr/eag/color/images/btn_wps.png)