製品・技術
TXRF分析概略
TXRF(Total reflection x-ray fluorescence : 全反射蛍光X線分析)は半導体ウエハ表面の微量金属汚染の評価に用いています。洗浄など、製造製造工程でウエハ表面に付着した金属汚染の分析に有効です。
非破壊での分析となり、半導体業界での金属汚染の評価には必要不可欠な分析手法になります。EAG Laboratoriesでは最大300mmウエハの評価に対応し、クリーンルーム(クラス10)に設置されています。
対象分野
- 半導体
用途事例
- 各種ウエハの金属汚染評価(50~300mmウエハ対応)
- 化合物ウエハの評価:GaN・GaAs・AlN・InP・GaP・Ge・Sapphireなど
- Siウエハ以外の評価
(汎用的に半導体汚染評価に用いられるVPD-ICP-MSは主にSiウエハのみ対応)
原理/特徴
特徴
- 定性・定量・高感度・非破壊分析
- ~300mmウエハ対応
- 2次元マッピング対応
- Al、NaおよびMgが測定可能
- ウエハのエッジ部も測定可能
制約
- 深さ情報(Depth profile)は取得できない
- 分析スポット:Φ10mm
- 高感度分析:研磨された表面が必要
- 取得元素によっては基板から発生したマトリックス元素の影響を受ける
検出原理
分析ビーム選択と検出下限
分析事例
TXRF:ウエハ上のCu汚染評価
TXRF:200mm SiウエハのNa、Mg、Al汚染マッピング評価
TXRF:化合物半導体ウエハの評価
GaAs・Sapphire・Ge・SiC・GdGa gament・InP・GaN・GaP基板など対応。
関連のある分析手法
- VPD-ICP-MS
SMART Chart
分析深さ一覧
- サイト内検索
- 新着ページ
-
- SEM-CL:カソードルミネッセンス分析 (2024年07月26日)
- TEM-EDS/EELS:透過型電子顕微鏡・元素分析 (2024年07月22日)
- PCOR-SIMS:Point by point Corrected 二次イオン質量分析法 (2024年07月17日)
- FIB-SEM:集束イオンビーム分析 (2024年07月09日)
- Kr85リーク試験:封止パッケージの気密性試験 (2024年05月27日)




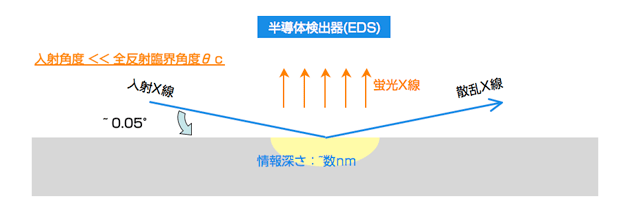






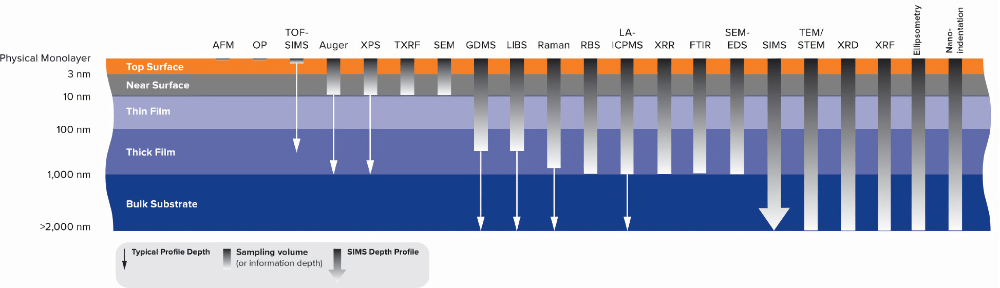




![足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内] 足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内]](https://www.atengineer.com/pr/eag/color/images/btn_wps.png)