SEM/断面SEM分析概略
SEM(Scanning Electron Microscope:走査型電子顕微鏡)では表面の凹凸像・組成コントラスト像を取得することができます。また、FIB-SEMやイオンミリング装置で試料の断面加工を行い、SEMで微細構造の分析を行うことができます。
*各分析手法の分析深さはSMART Chartからご覧いただけます
比較:反射電子像と
二次電子像
電子線と個体の相互作用
光路構成
対象分野
- 半導体
- エレクトロニクス
- 自動車
- 航空宇宙
- 鉄鋼
- 先端材料
- エネルギー
- メディカルデバイス
原理/特徴
二次電子像
SEMの基本原理は、真空中で試料に電子線を入射させ、その際に発生した二次電子を画像化しています。そのため、SEM像は白黒コントラストになり、コントラストは二次電子線の信号の強弱を示すことになります。
二次電子とはその名の通り、入射電子(一次電子)により励起され発生した電子になります。試料に電子線が入射されると、次々と二次電子が発生します。しかしながらこの二次電子は、物質中をあまり長い距離は移動できません。そのため、試料表面近くで発生したものしか、試料から真空中・検出器まで進んでいけません。この二次電子の脱出深さは概ね数nmから十数nmです。
斜面の右側で発生した二次電子は、それほど長い距離を移動せずに外に脱出できます。そのため、傾きが大きいほど多くの2次電子が脱出できることになります。ただし、逆に斜面の左側では、脱出できる2次電子は水平な場合よりもさらに少なくなります。(外に脱出するまでの実質的な距離が長くなるため)
このように、二次電子は試料表面の形状により発生量が変わるため、結果的に試料表面の凹凸情報を反映した像を取得することができます。尚、二次電子は材料によっても発生効率は異なります。ただし、通常は試料形状の方がコントラストに大きく影響します。
反射電子像
試料に電子線を照射した際、色々な信号が発生します。SEMでは二次電子と反射電子を取得するのが一般的です。二次電子は上記の通り入射電子から励起された電子です。
それに対し、照射した電子が試料表面で反射した電子(実際には後方散乱)が反射電子になります。反射電子は試料を構成する元素により発生量が異なり、原子番号が大きいほど発生量が多くなる性質を持っているため、試料中の組成分布を確認する手法として良く使われます。
このコントラスト(原子番号が大きいほど信号量が大きい)は、TEMのHAADF像(Zコントラスト)にとても似ています。
| 二次電子像(SE) | 反射電子像(BSE) | |
| 情報深さ (脱出深さ) |
試料表面 数nm |
二次電子よりかなり深い (~100nm~) |
| 電子エネルギー | 弱 | 強 |
| チャージアップ | 影響を受けやすい | 影響を受けにくい |
| 特徴 | 試料表面の表面形状に敏感 | 試料の組成変化に敏感 |
| その他 | 表面凹凸情報も取得可能 |
分析事例
断面SEM
Arイオンミリング処理をしたCu
SEM観察
微粒子膜
関連のある分析手法
- IGA
- ETV-ICP-MS
- ICP-MS
- ICP-OES
SMART Chart
分析深さ一覧
- サイト内検索
- 新着ページ
-
- SEM-CL:カソードルミネッセンス分析 (2024年07月26日)
- TEM-EDS/EELS:透過型電子顕微鏡・元素分析 (2024年07月22日)
- PCOR-SIMS:Point by point Corrected 二次イオン質量分析法 (2024年07月17日)
- FIB-SEM:集束イオンビーム分析 (2024年07月09日)
- Kr85リーク試験:封止パッケージの気密性試験 (2024年05月27日)




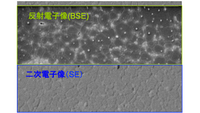

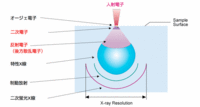
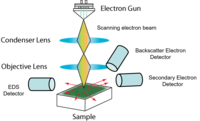
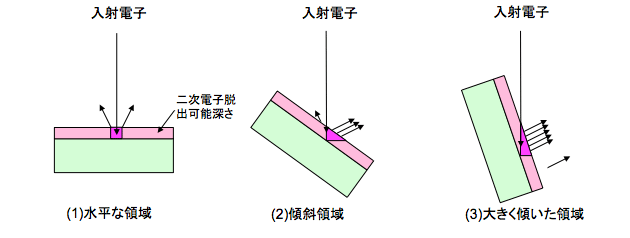
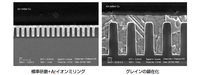
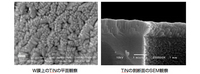

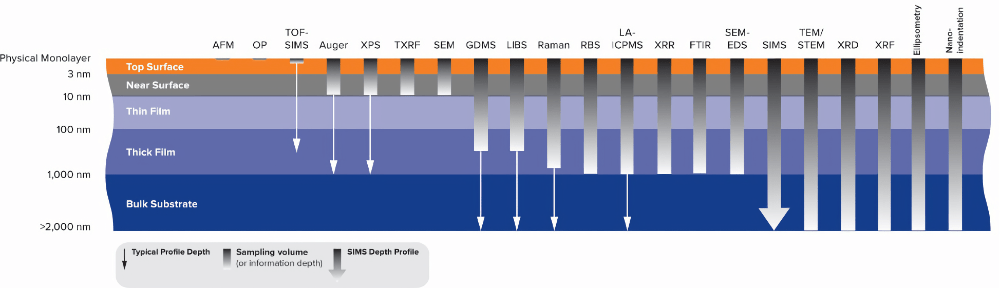




![足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内] 足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内]](https://www.atengineer.com/pr/eag/color/images/btn_wps.png)