TEM/STEM分析概略
TEM/STEM(Transmission Electron Microscope/Scanning transmission electron microscope:透過型電子顕微鏡/走査型透過型電子顕微鏡分析)は、電子ビームを使用してサンプルを画像化する分析手法です。
TEM/STEMの空間分解能はSEMより優れていますが、多くの場合複雑なサンプル調製が必要です。また、近年ではSTEMに球面収差補正レンズを搭載したAC-STEM(CS補正機能付きSTEM)により従来のSTEMよりも高分解能での分析が可能になりました。
EAG LaboratoriesではTEM/STEMを20台以上所有し、試料作製用のFIB-SEMを30台以上所有しています。また、元素分析を行うEDS/EELSも複数台所有しています。分析に充分な設備数を所有しているため、TEM/STEM分析は常に短納期でご対応することが可能になっています(参考納期:6~8営業日)。
対象分野
- 半導体
- エレクトロニクス
- 自動車
- 航空宇宙
- 鉄鋼
- 先端材料
- エネルギー
- メディカルデバイス
用途事例
| 超高分解能分析 |
|
| 結晶情報 |
|
| ナノ領域での組成分析 |
|
対象試料の事例
- Ⅲ-Ⅴ・GaN系薄膜・ デバイスの断面構造観察及び元素分析
- Si系薄膜・ デバイスの断面構造観察及び元素分析
- その他各種固体材料の形態・構造観察
- 燃料電池触媒の観察
- 有機EL素子等、有機デバイスの構造評価
原理/特徴
試料をFIB-SEMなどで薄片化し、薄片試料に電子線を照射します。
試料から透過した電子線の透過分布から高分解能像を得たり、結晶情報、組成情報、電子線回折により試料の構造情報を得ることができます。
- ナノスケールレベルの分解能で構造・形態観察
- 元素像の高分解能マッピング
- 格子像観察
- Zコントラスト像観像
- 原子スケールの観察像(AC-STEM)
光路構成
比較:TEMとSTEMの違い
TEM
回折コントラスト(散乱コントラスト)が得意なため結晶性に関する情報取得に長けている。
STEM
HAADF像(Z[原子番号]コントラスト像)が取得可能。
ドーナツ型の検出器を使用するので、回折コントラストの影響はかなり弱められ組成コントラスト取得に長けている。
観察事例
サファイア基板上のGaN膜(同一試料をTEMとSTEMで観察し比較)
図1:TEM像
図2:HAADF像
(Zコントラスト像)
図1では、界面に存在するひずみによるコントラスト・欠陥の様子が良く分かる一方、基板とGaN膜自体では明確にはコントラストの差は認識できません。
一方図2では図1で見られた欠陥、基板界面のひずみといった回折コントラストに起因するコントラストはほとんど見られていません。
その代わり、基板とGaN膜そのもののといった組成の違いによるコントラスト差ははっきりついているのが分かります。
このようにTEMは回折コントラスト(結晶に起因)に起因する分析(例:欠陥評価、電子線回折測定、グレインサイズの評価など)に向いており、STEMは組成に起因するコントラストに関係分析(例:化合物半導体の積層構造の確認など)に用いると有効であることが分かります。
また、STEMは電子線プローブを走査できることから、EDS/EELSといった面分析を行えること、TEMに比べると比較的、薄片試料厚さが厚くても像の確認ができます。そのため、故障解析などで薄片試料を少し厚めにして作製し(内部に異常部を挟み込むように)観察するようなケースにも多く利用可能です。
分析事例
TEM/STEM:AC-STEMのABFを用いたGaN結晶の極性評価
Ga極性面とN極性面は成長速度・表面拡散が異なるため結晶性に大きく影響します。
ABFの原子像とシミュレーション像を比較することで直接極性を決定することが可能です。
TEM/STEM:FIB-SEMを用いた
3D NADAフラッシュメモリーの高精度断面TEM試料作製技術
高アスペクト比ホールのメモリセル解析には、深さ方向に均一な厚さでカーテン効果等のアーティファクトの影響を回避したTEMラメラの作成が必要不可欠です。
EAG Laboratoriesでは均一な厚みでアーチフェクトを抑えたTEM試料を高い再現性で作成できる技術を確立しています。
TEM/STEM:高アスペクト比構造の3D NADAフラッシュメモリー断面TEM分析
深さ約6umのホール各部(TOP, MID, BOT)のPoly-Siチャネル・フローティングゲートSiO2層・チャージトラップSiN層・スペーサーSiO2層の詳細観察が可能。
TEM/STEM:3D NAND フラッシュメモリーのEELSによる
断面マッピング・断面ラインスペクトル分析
元素マッピング・ライン分析の結果、ワードラインとして使用されているW・High-kゲート絶縁膜のAl2O3・バリア層のTiN・フローティングゲートSiO2層を明確に特定可能。
TEM/STEM:Multiple FIB cutを用いた
3D NADAフラッシュメモリーの高精度平面TEM試料作製技術
断面・平面方向など多角的な解析を実施することにより高精度なナノメートルスケールの膜厚評価が可能。
TEM/STEM:3D NAND フラッシュメモリーのEELSによる平面マッピング分析
EELSはEDSよりも軽元素を高感度分析が可能、そのためN・O等といった軽元素の高感度構造解析が可能。
TEM/STEM:FIB-SEMを用いた
Fin FET構造 Fin cut TEMラメラのSTEM-HAADF分析
高分解能STEM観察ではFin FET構造をSi原子が確認可能なナノメータースケールで評価可能。
TEM/STEM:マシンラーニング(機械学習)を用いた自動膜厚分析
最新のマシンラーニング技術を用いた自動膜厚測定、取得したSTEM像から境界線を定義し統計的な数値解析が可能。
関連のある分析手法
SMART Chart
分析深さ一覧
- サイト内検索
- 新着ページ
-
- SEM-CL:カソードルミネッセンス分析 (2024年07月26日)
- TEM-EDS/EELS:透過型電子顕微鏡・元素分析 (2024年07月22日)
- PCOR-SIMS:Point by point Corrected 二次イオン質量分析法 (2024年07月17日)
- FIB-SEM:集束イオンビーム分析 (2024年07月09日)
- Kr85リーク試験:封止パッケージの気密性試験 (2024年05月27日)








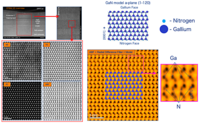
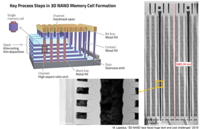
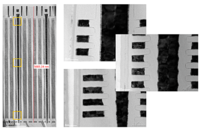

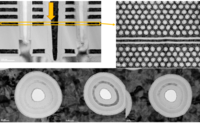

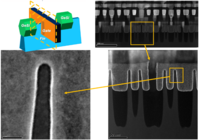
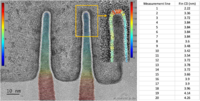

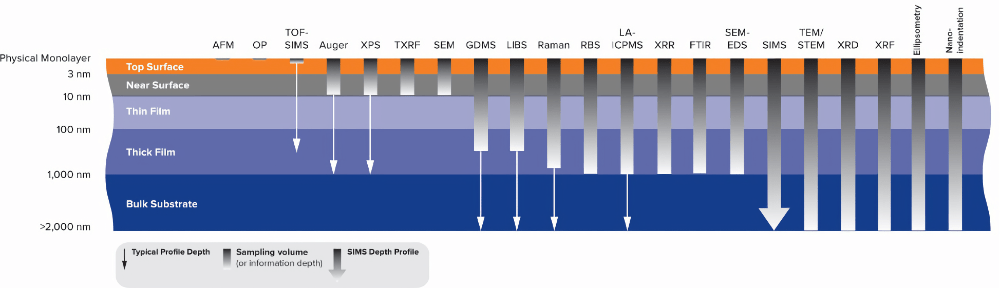




![足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内] 足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内]](https://www.atengineer.com/pr/eag/color/images/btn_wps.png)