事例
■TDDB試験の概要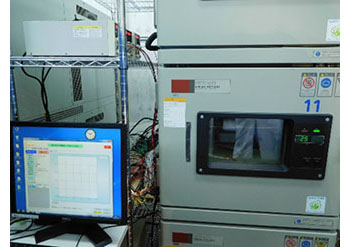
半導体の酸化膜に電圧を継続的にかけていると、時間が経つにつれ酸化膜の破壊が発生します。
これを酸化膜破壊(TDDB: Time Dependent Dielectric Breakdown)といい、半導体の寿命や信頼性を考える上で、最も重要な要因のうちの一つです。このTDDB試験においては、電圧加速による寿命試験を行います。
■TDDB試験の特徴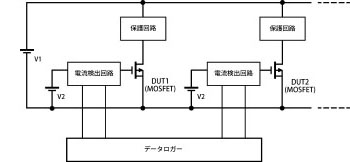
測定系を右に示します。カスタム試験装置により、
・複数電圧やドレイン-ソース電圧印加、ゲート-ソース電圧印加なども可能です。
・恒温槽に入れて、温度加速と組み合わせて試験を行うことも可能です。
・その他特殊なカスタム試験もご相談承
ります。
【試験スペック】
印加電圧:最大3kV(200mA)
検出電流:1nA(検出抵抗1MΩ挿入)
環境温度:恒温槽使用時、最高150℃、オーブン使用時、最高200℃(電圧1㎸以下)
※200℃以上は要相談
【その他応用例】
・NG閾値の検出
数V/秒で最大XkVまで電圧上昇させ、何VでNGが発生するか確認する。
・ステップ状に電圧を印可
Xボルトから、1分ごとに数V/STEPでYボルトまで上昇させながら印可。
最大600Vまで可能。
■試験結果例
試験結果例です。寿命10年を想定した場合は、試験デバイスのゲート電圧を、20V以下で使用することが必要となります。
- サイト内検索
- クオルテック公式サイト
- 新着ページ
-
- 加工対象物を選ばない新工法「レーザデスミア」 (2024年06月11日)
- 基板の実装不良における様々な観察事例④(はんだボール) (2024年05月28日)
- 基板の実装不良における様々な観察事例③(未溶融) (2024年05月14日)
- PY(パイロライザー)による熱抽出・熱分解GC/MS (2024年04月30日)
- 基板の実装不良における様々な観察事例②(基板要因) (2024年04月16日)






![足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内] 足で稼ぐ営業を見直しませんか?[営業支援サービスのご案内]](https://www.atengineer.com/pr/qualtec/color/images/btn_wps.png)